-
Chiplet 产业格局全景解析
价值投机小学生
 / 2022-09-04 08:47 发布
/ 2022-09-04 08:47 发布1
先进封装行业概览
封装是指将生产加工后的晶圆进行切割
、 , , , 、 。 随着半导体先进制程不断往7nm/5nm
, , 、 。 面对此难题
, , 。 先进封装采用了先进的设计思路和先进的集成工艺
, , 。 先进封装工艺包括倒装焊(FlipChip)
、 、 ( ) 、 、 。 据 Yole 数据
, 。 , 。 预计到 2025年先进封装的全球市场规模将达到 420 亿美元
, 。 相比同期整体封装市场 (CAGR=5%)和传统封装市场
, 。 芯片整合已演进至2.5D/3D及Chiplet封装
: 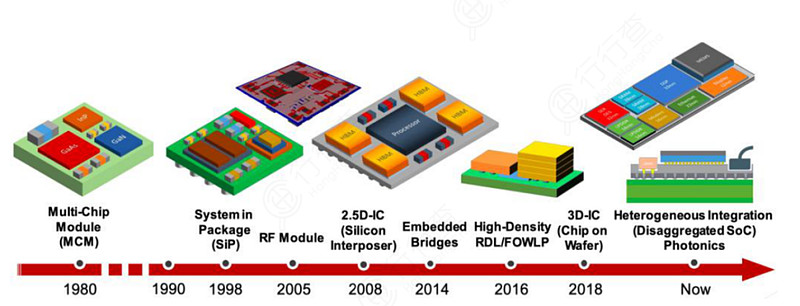
资料来源
: Cadence2
Chiplet 行业概览
随着半导体制程节点的持续演进
, 、 , 。 在此背景下
, 。 作为先进封装技术的代表
, ( ) , 。 Chiplet 实现原理与搭积木相仿
, , , , , 、 , 。 Chiplet 的概念源于 Marvell 创始人周秀文博士在 ISSCC 2015 上提出的 Mochi
( , ) , , 。 基于Chiplet 的异构架构应用处理器:
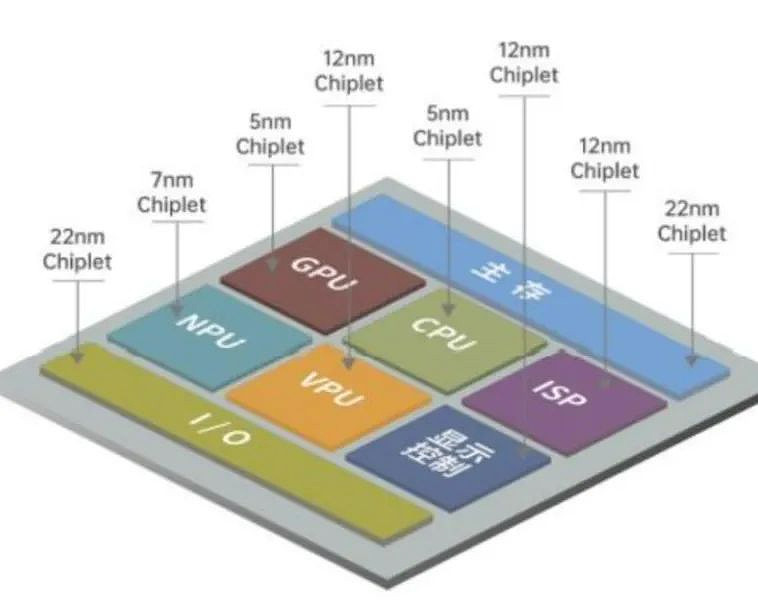
小程序
通过Chiplet技术
, , , , 。 Chiplets结构
: 
资料来源
: Omdia, , Chiplet模式具备开发周期短
、 、 。 、 、 、 。 其作用主要包括
: 降低单片晶圆集成工艺良率风险, , , , , , 、 、 。 
资料来源
: 来源: CEIA电子制造3
Chiplet 市场格局
目前Chiplet已经有少量商业应用
, , 。 随着 Chiplet 逐步发展
, 。 2022年3月
, —— UCIe( , ) , , 。 。 UCIe联盟为Chiplet制定了多种先进封装技术
, 、 、 。 UCle发起人为 Intel
、 、 、 、 、 、 、 、 。 UCIe联盟致力于推行Chiplet互联规范
, 、 、 、 。 对于中国半导体而言
, 。 国内企业紧跟产业趋势
, , , 。 国内企业中
, 、 、 、 、 、 、 、 、 、 、 、 、 、 、 、 、 、 、 。 
资料来源
: UCle、 Chiplet开启了IP新型复用模式
Chiplet的实现开启了IP的新型复用模式
, 。 不同功能的IP
, 、 、 , , , 。 AMD 公司是第一个引入小芯片架构的供应商
。 ( ) ( ) , “ 老旧制程” 生产的 Chiplet 继续应用到下一代产品中以节约成本, 、 。 AMD IO Chiplet 的复用
: 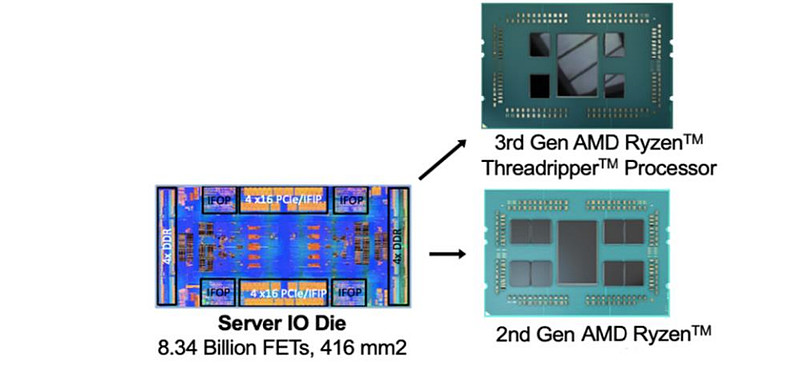
就Chiplet和半导体IP的联系而言
, , 。 半导体IP的市场参与者可大致分为两类
: 新思科技和Cadence是与EDA工具捆绑型的半导体IP供应商, ; 其余是在细分领域提供专业的IP核厂商。 当前IP市场仍然被英美国家高度垄断
, 、 ( ) ( ) 。 , 。 国内芯原股份在全球前七名半导体IP授权供应商中
, 。 , , 。 国内产业链相关厂商也在积极布局
。 通富微电在先进封装方面公司已大规模生产 Chiplet 产品
, , 。 , ( ) 、 , 。 长川科技是国内领先的集成电路测试设备企业
, 。 , 。 兴森科技是国内 IC 封装基板领先企业
, 。 , , 。 寒武纪2022年3月30日回复称思元370是寒武纪首款采用chiplet
( ) , , , 。 摩尔定律减缓带来了小芯片的设计需求
, 、 。 总体来看
, , 。 根据研究机构 Omdia 报告
, , 。 Chiplet作为目前受到广泛关注的新技术
, , , , 、
水晶球APP
高手云集的股票社区
X




 公安备案号 51010802001128号
公安备案号 51010802001128号