-
Chiplet:延续摩尔定律——先进制程替代之光!
价值投机小学生
 / 2022-08-09 12:12 发布
/ 2022-08-09 12:12 发布作者
: 蒋高振, : 浙商证券设计IP公司
: ; 封装载板
: 。 1.
Chiplet
: ! 1.1.Chiplet助力先进制程弯道超车
Chiplet(芯粒)模式是在摩尔定律趋缓下的半导体工艺发展方向之一
。 近几十年来
, , , 。 、 、 , , 。 后摩尔定律时代的主流晶片架构SoC (系统单晶片)推动摩尔定律继续向前发展
, , , 。 Chiplet模式或存在弯道超车机会
, , , , , 、 。 , ( 、 ) 、 、 。 Chiplet方案对封装工艺提出了更高的要求
。 , , , , , 、 、 。 , 。 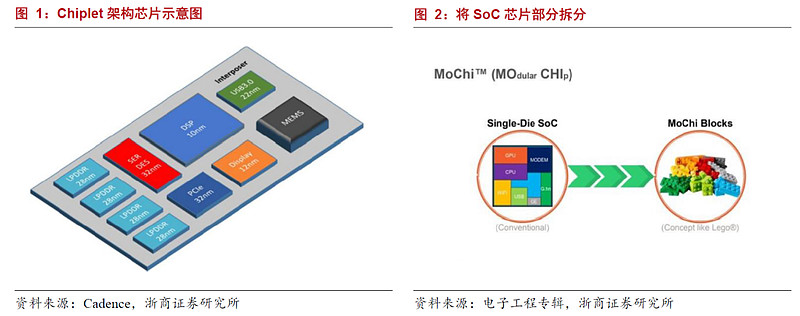
国际巨头成立UCIe产业联盟促进互联协议标准
。 , 。 , , , 。 英特尔
、 、 、 、 、 、 、 、 、 , , 。 , , 。 1.2. 灵活性+低成本催生Chiplet需求
与传统的SoC方案相比
, 、 、 , 。 Chiplet模式可以自由选择不同分区的工艺节点
。 , 。 、 、 、 , 、 , 。 , , , 。 Chiplet模式有利于提高良率
, 。 , , , 。 , , , 。 Chiplet模式可以实现产品重复使用
, 。 , , 。 , , 。 Chiplet模式目前还暂时存在对先进封装技术要求高
、 。 、 ; 要保证各裸芯片之间的数据实现高速、 ; 相对先进制程Chiplet模式散热能力较差, 。 2.
巨头布局
: ! 2.1. 华为
: 华为推出基于Chiplet技术的7nm鲲鹏920处理器
。 , , , , 、 、 , 。 , , 。 , 。 。 , , 。 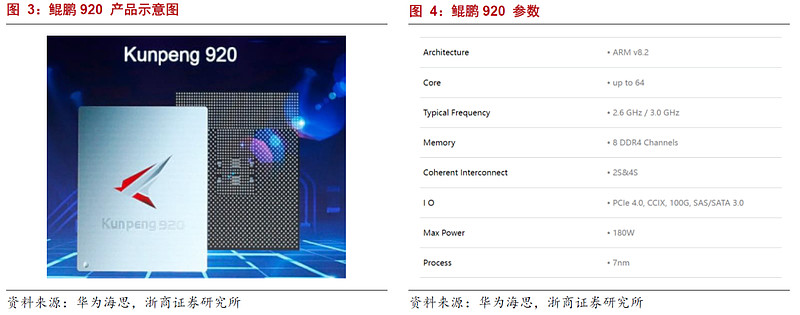
2.2. AMD
: AMD联手台积电推出3D Chiplet产品
。 , , 。 , , 。 , 。 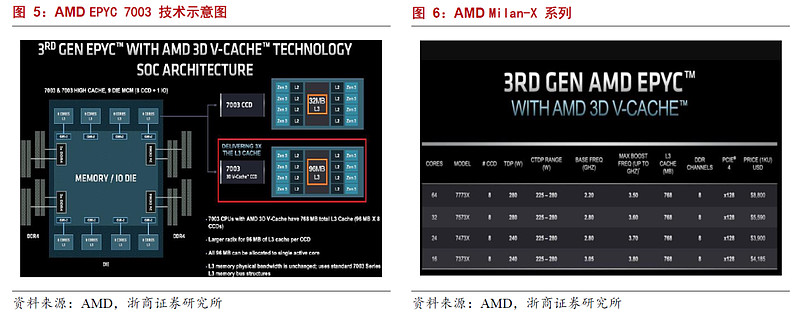
2.3. 苹果
: 苹果推出采用台积电CoWos-S桥接工艺的M1 Ultra芯片
, 。 , , , 。 , , 。 , ( ) , , 。 , 。 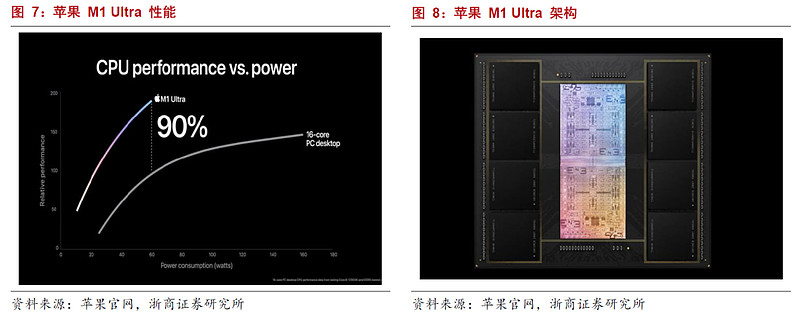
3.
产业革新
: ! 3.1. 先进封装提升设计弹性
Chiplet目前封装方案主要包括2.5D封装
、 、 。 ( ) , ( ) , , ( ) ( ) , , 。 , , ( ) , 。 , 。 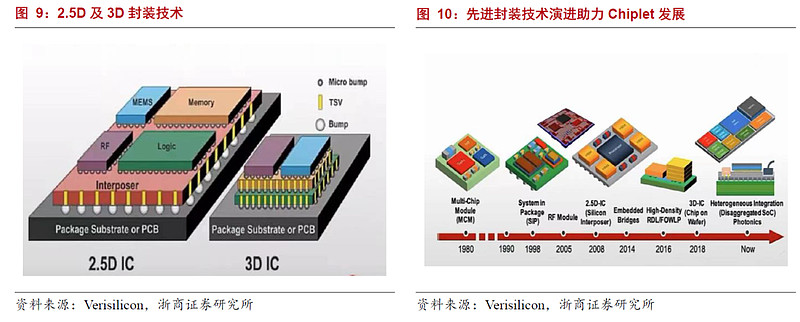
国际厂商积极布局Chiplet封装
。 、 、 , 。 Intel推出3D堆叠异构系统集成技术Foveros与嵌入式多芯片互联桥接技术EMIB
。 , , 。 , 、 , 。 , , , 。 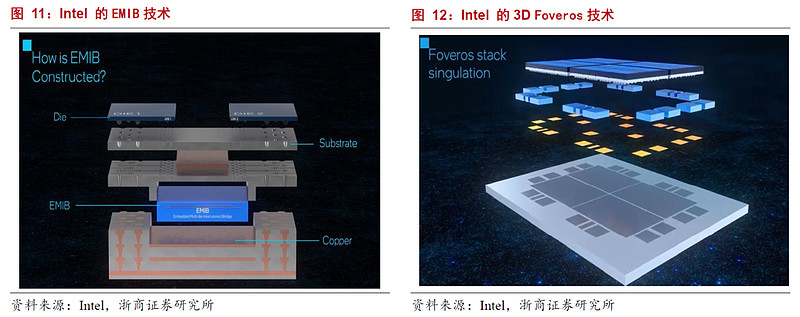
TSMC推出的3D Fabric
, 、 。 , , ( ) ( ) , , 、 、 。 , , 。 。 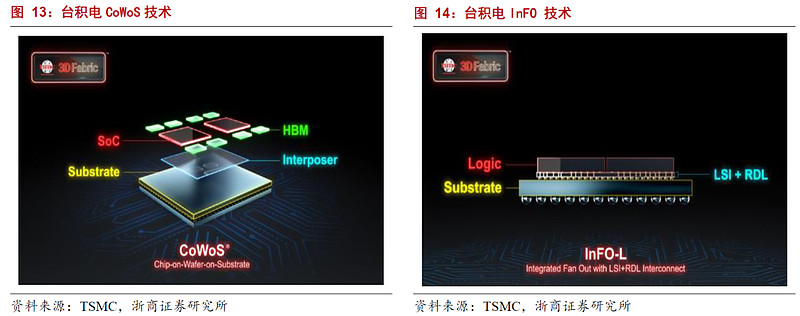
国内企业通富微电
、 。 , , , , , , , 。 , , 、 、 、 、 、 , 。 Chiplet封装推动对芯片测试机的需求增长
。 , , , , 。 、 , 。 3.2. IP复用提高设计经济性
Chiplet的发展有利于实现
“ IP芯片化” 。 , , 。 , 。 , , 。 
芯原股份作为国内最大的半导体IP供应商有望受益Chiplet发展
。 、 , , , 。 “ IP芯片化” 和“ 芯片平台化” 来实现Chiplet产业化, 、 , 。 , , 、 、 , 。 4.
受益标的
: ! 先进封装
: , 。 , 。 , 、 。 IP公司
: , 。 , , 。 封测设备
: Chiplet方案的落地的关键便在于先进封装技术的实现, 。 , 。 , 、 、 、 。 封装载板
: 、 、 , 、 , 。 、 ,
水晶球APP
高手云集的股票社区
X




 公安备案号 51010802001128号
公安备案号 51010802001128号