-
中信建投:大算力时代的先进封装投资机遇
机构研报精选 / 2023-04-05 13:48 发布
大算力应用如高性能服务器(HPC)和自动驾驶(ADAS)取代手机/PC成为新一轮半导体周期驱动力,后摩尔定律时代高端封装工艺迭代成为新的发展趋势。以Chiplet为代表的2.5D/3D封装形式成为大芯片标配,TSV/RDL/Fan-out等高端封装技术带来封装环节价值占比提升。全球晶圆代工龙头台积电打造全球2.5D/3D先进封装工艺标杆,未来几年封装市场增长主要受益于先进封装的扩大。 
1、应用:大算力应用如高性能服务器(HPC)和自动驾驶(ADAS)取代手机/PC成为新一轮半导体周期驱动力,后摩尔定律时代高端封装工艺迭代成为新的发展趋势。以台积电下游应用来看,HPC的收入增速从2020年Q3超过手机后保持持续领先,对应的营收占比在在2022年Q1首次超过手机成为台积电下游第一大应用,相比之下封测厂商在高价值量的运算类电子占比仅为16%。我们认为随着大算力需求提升,先进封装替代先进制程成为降低单位算力成本的最佳方案,进而拉高运算电子在封测厂商的价值量。 2、工艺:以Chiplet为代表的2.5D/3D封装形式成为大芯片标配,TSV/RDL/Fan-out等高端封装技术带来封装环节价值占比提升。半导体价值量的增长下游从手机/PC向高算力的HPC和ADAS转移,封装工艺开始向Chiplet为代表的2.5D/3D封装转移,从封装工艺流程来看,晶圆代工厂基于制造环节的的优势扩展至TSV工艺,封测厂参与较多的是RDL和Fan-out等封装工艺,随着高算力芯片整体封测市场扩容,封测厂商逐步扩大2.5D和3D封测布局。 3、市场:全球晶圆代工龙头台积电打造全球2.5D/3D先进封装工艺标杆,未来几年封装市场增长主要受益于先进封装的扩大。目前先进封装营收规模最大是晶圆代工龙头台积电,预计2022年先进封装贡献了53亿美元,全球封测龙头日月光和安靠都推出了3D封测工艺平台,积极抢占先进封装的份额。预计2027年先进封装市场规模增至651亿美元,2021-2027年CAGR达到9.6%,先进封装成为大算力时代封装厂商新的增长动能。 








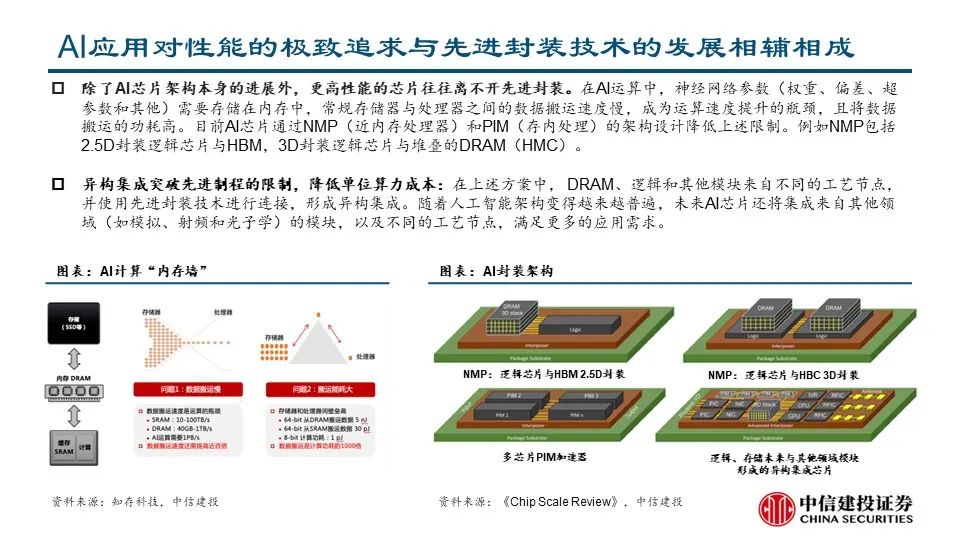

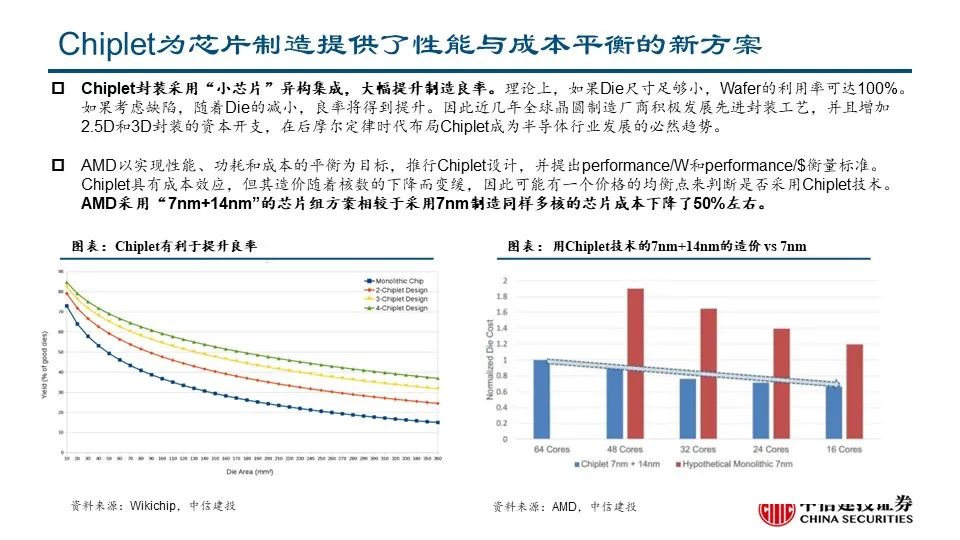
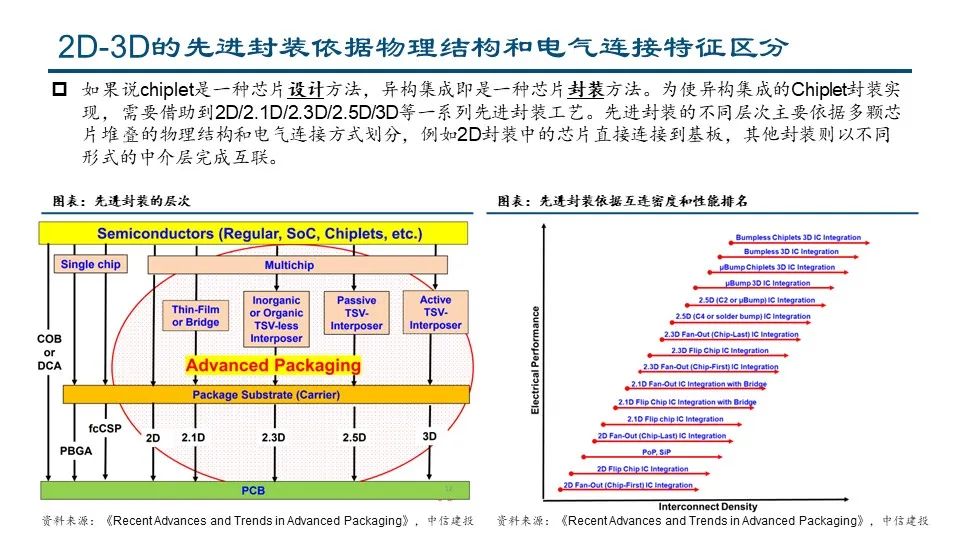
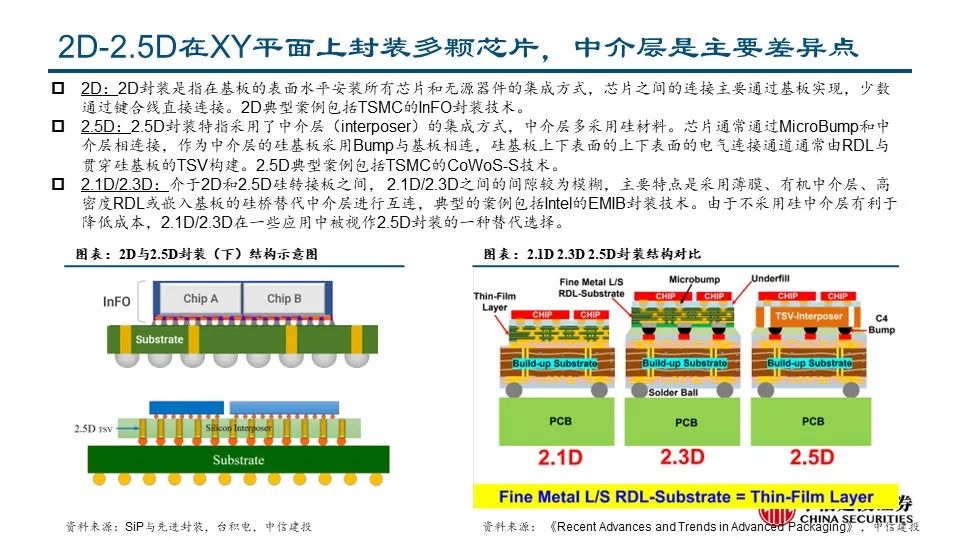
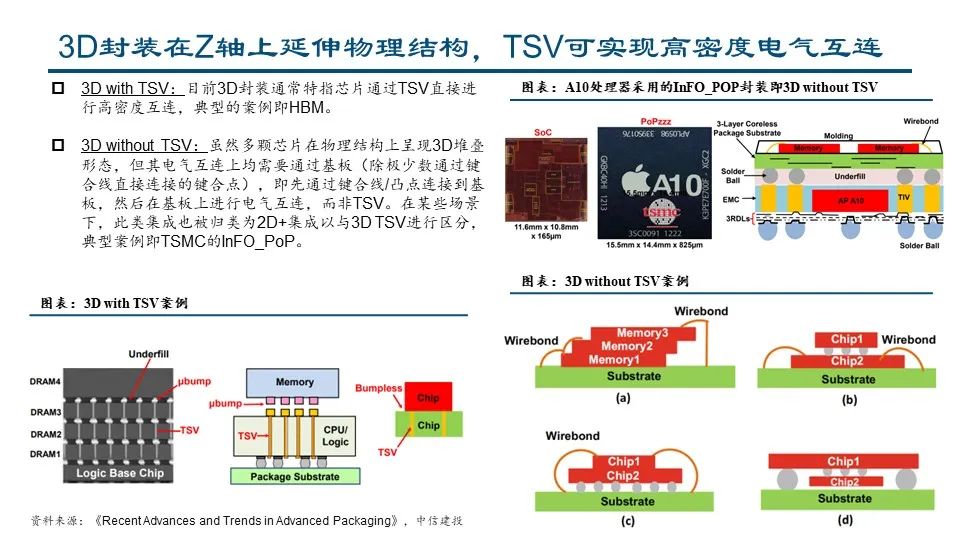
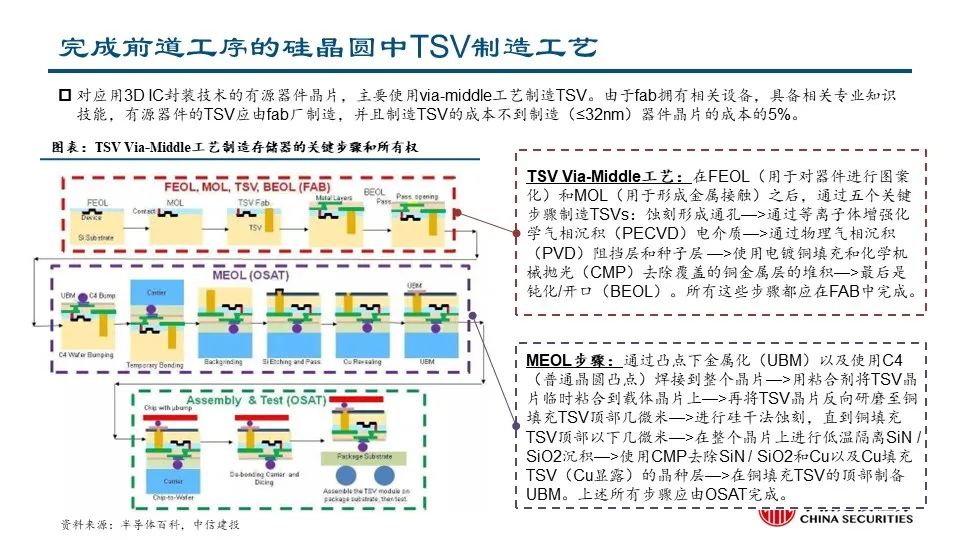
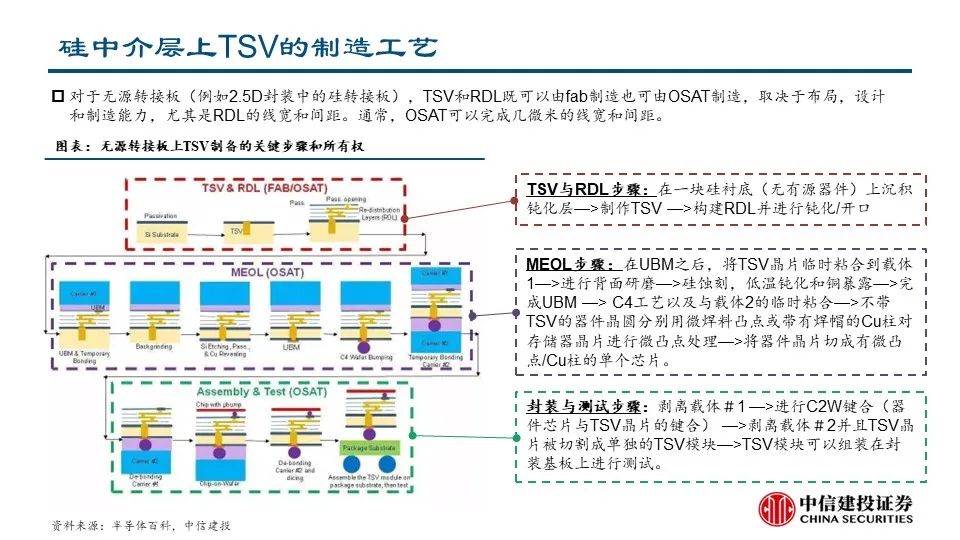
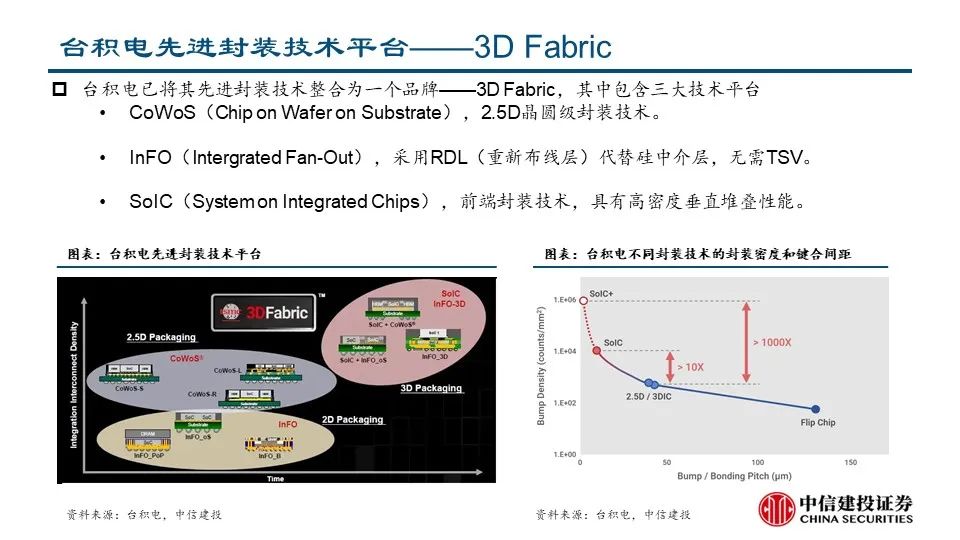
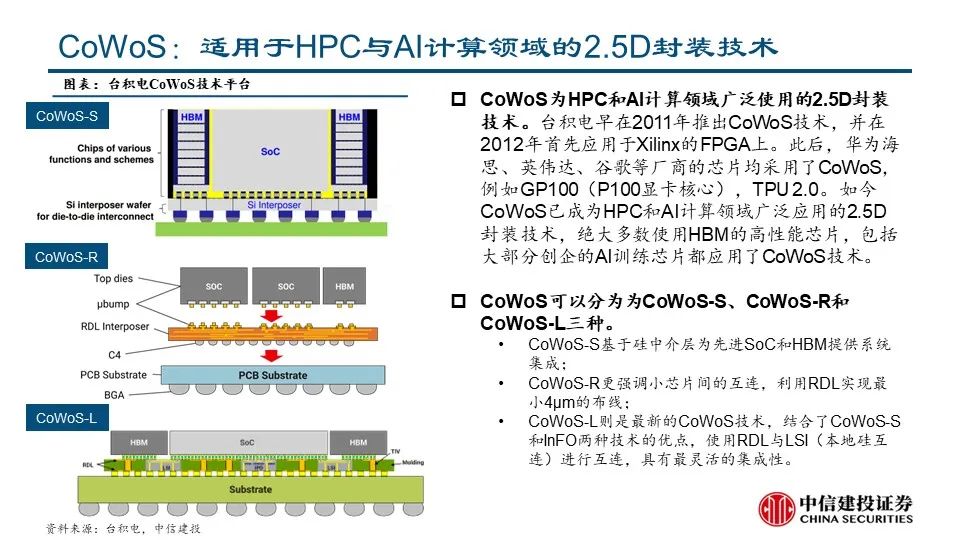
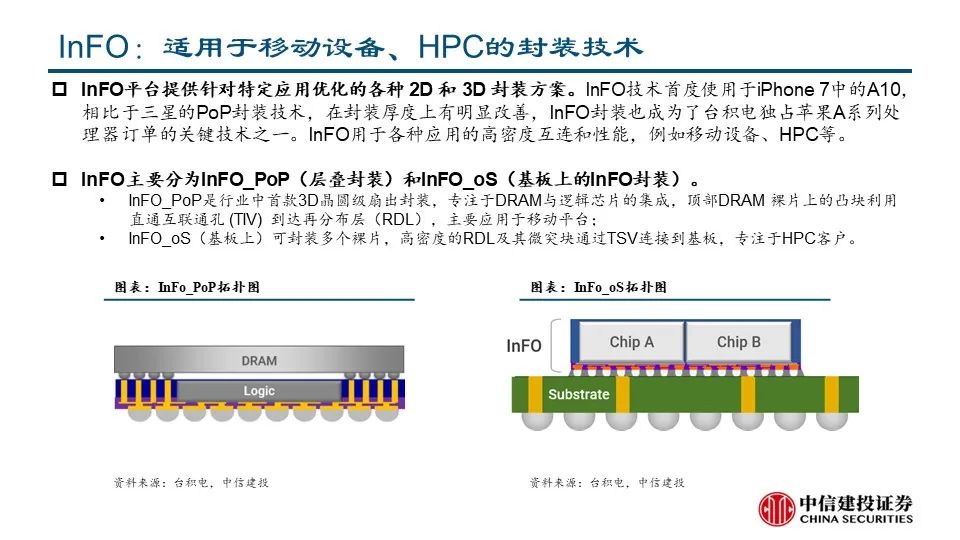
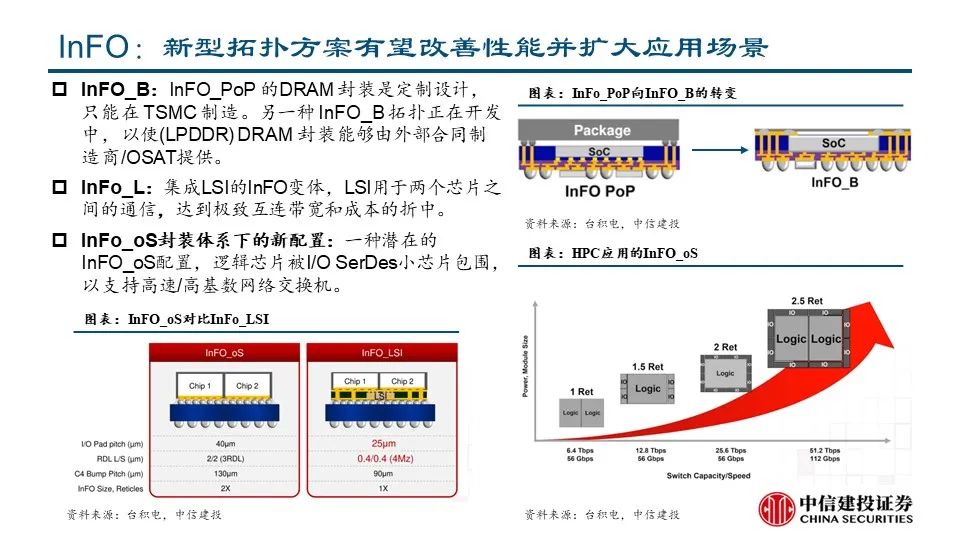
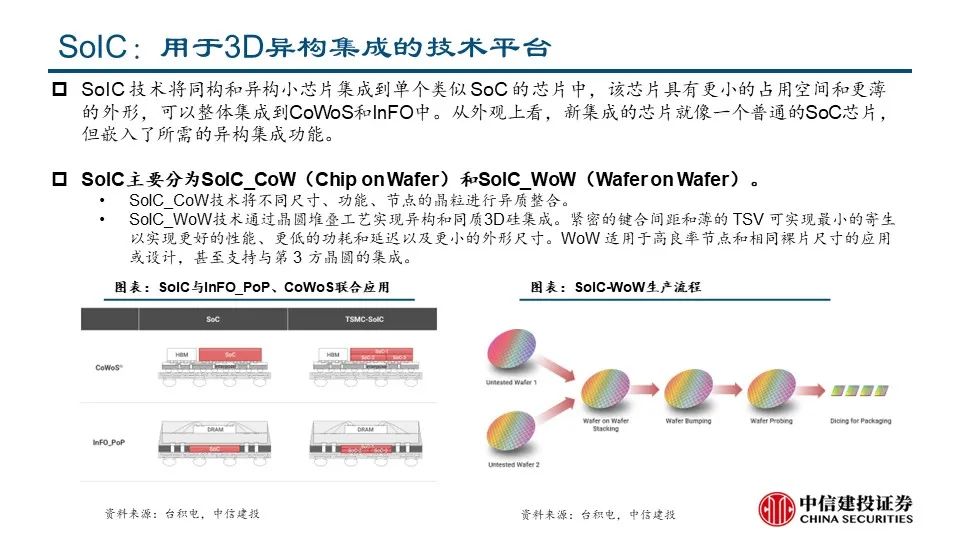
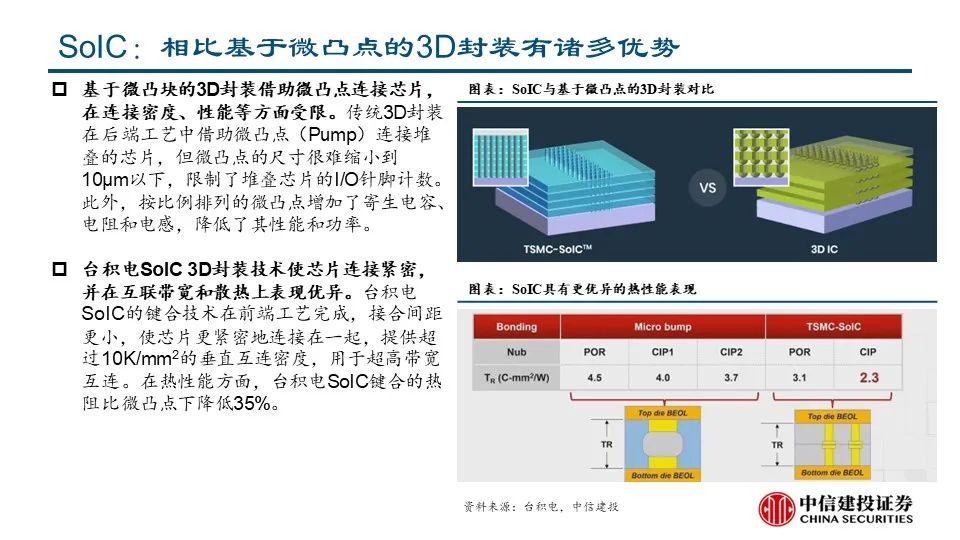
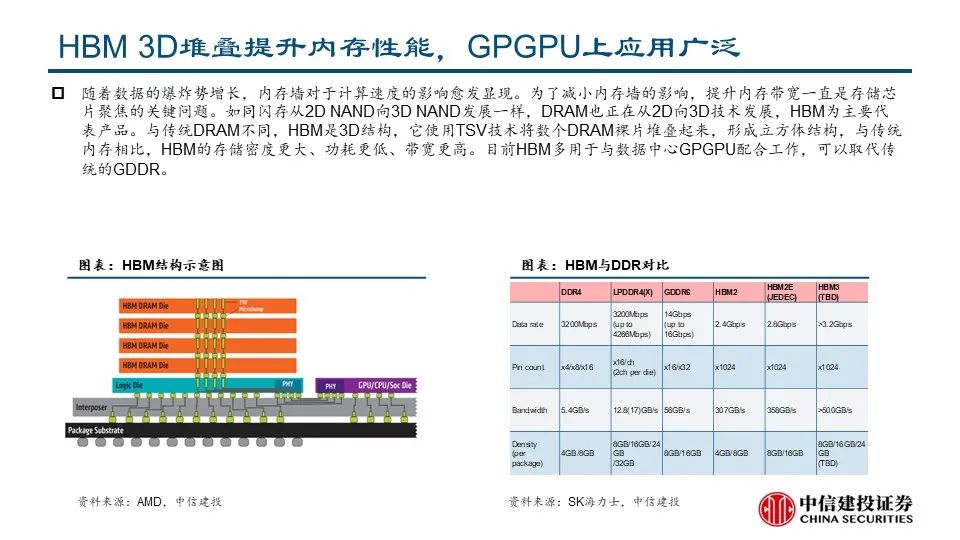
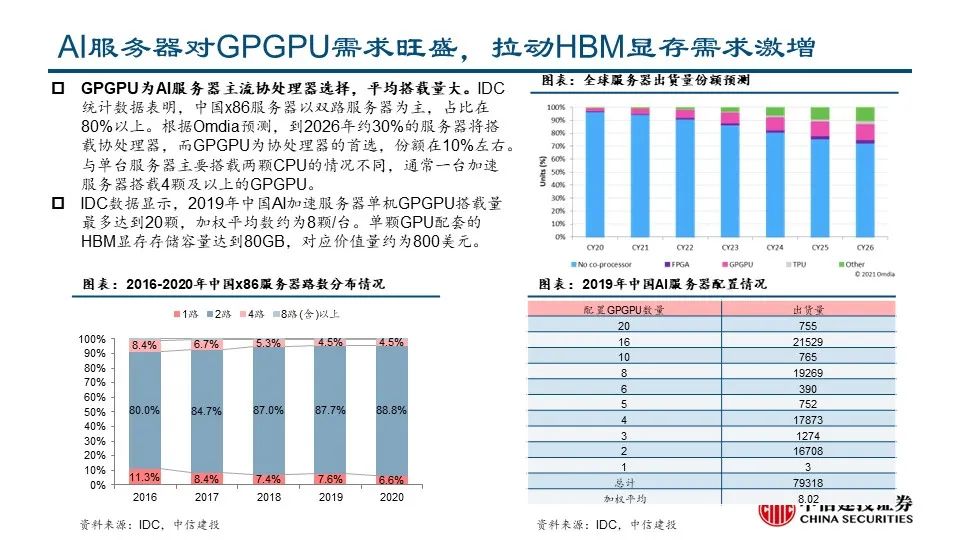

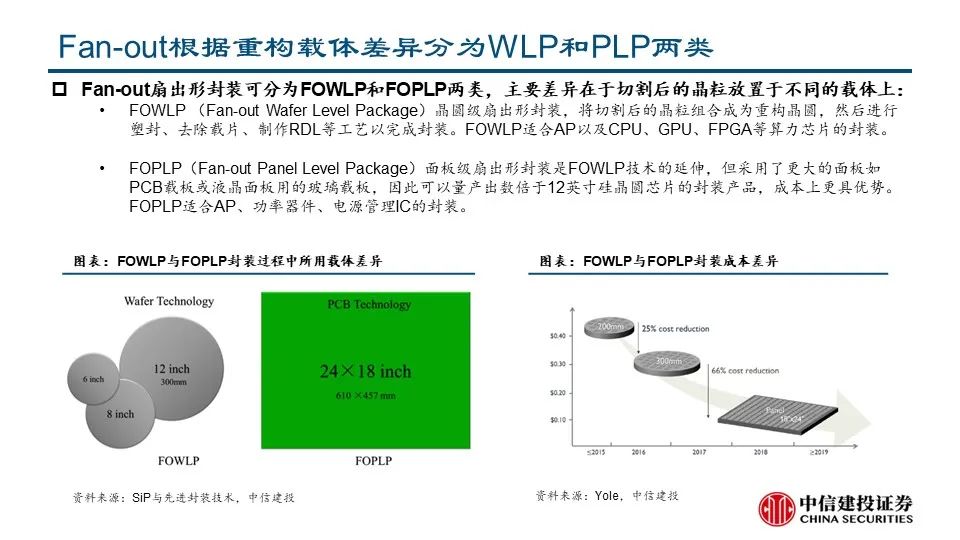
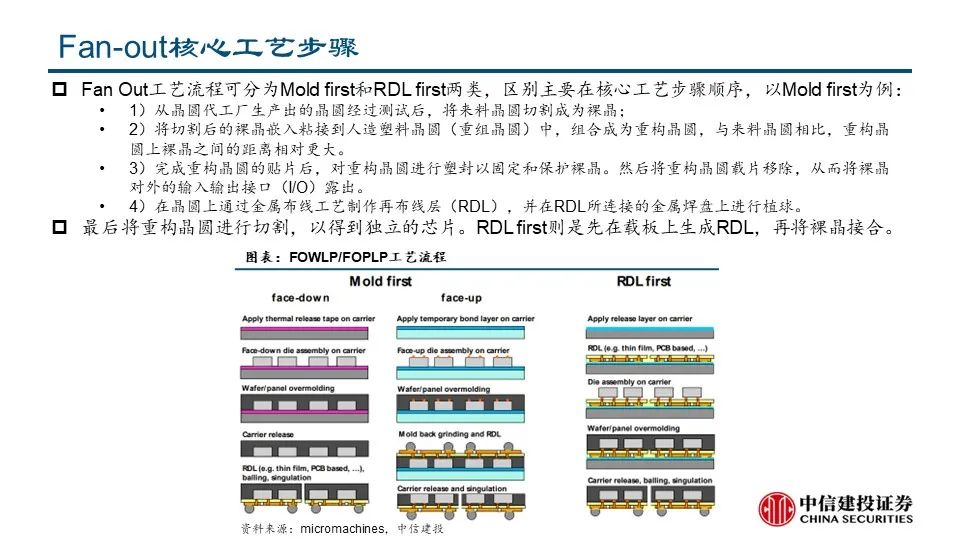





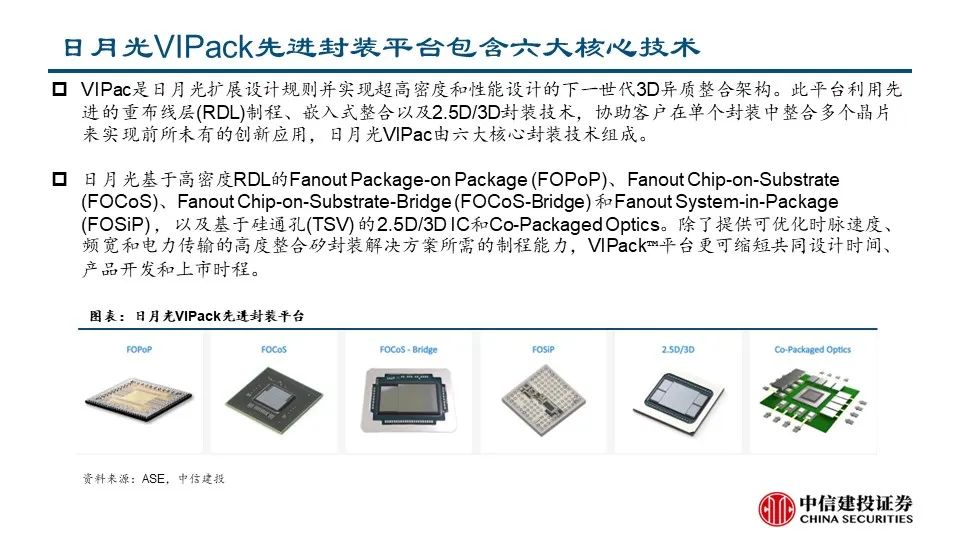
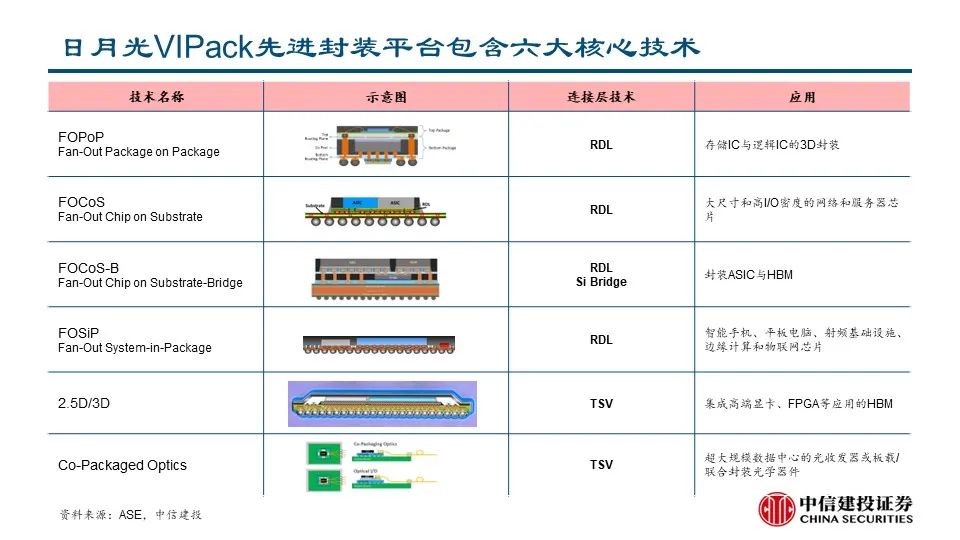
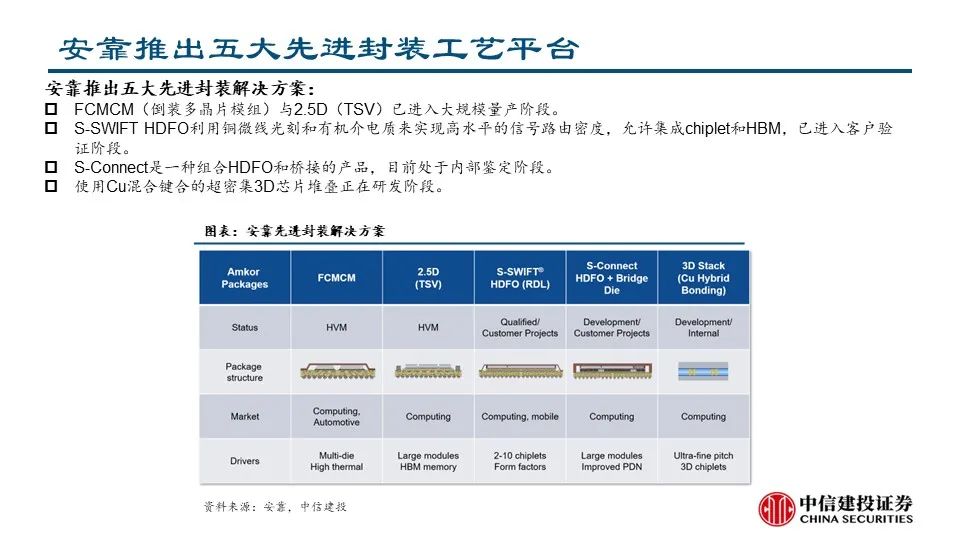
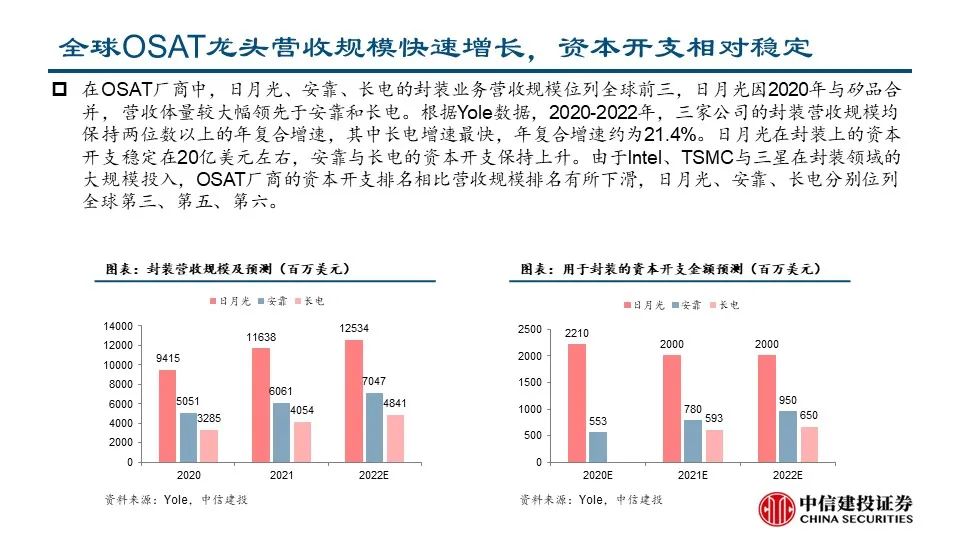




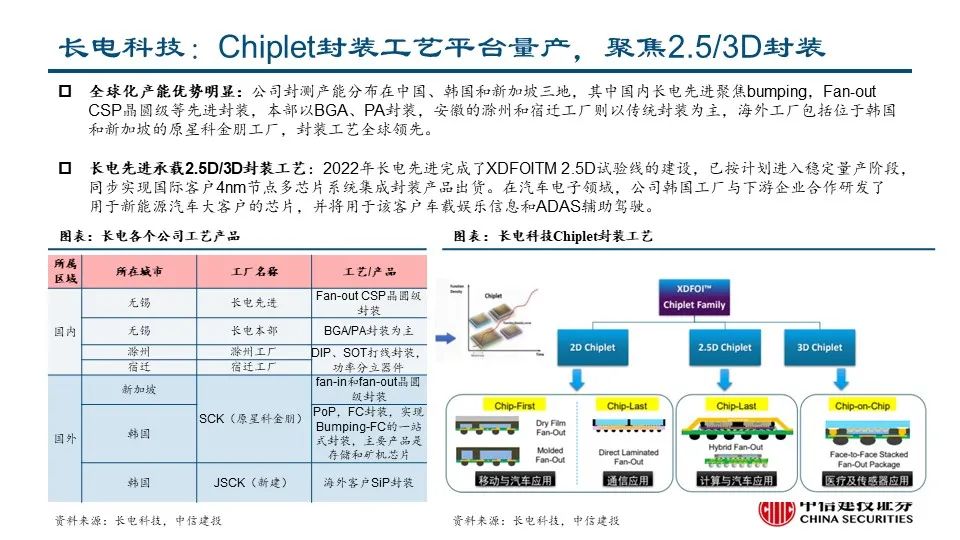

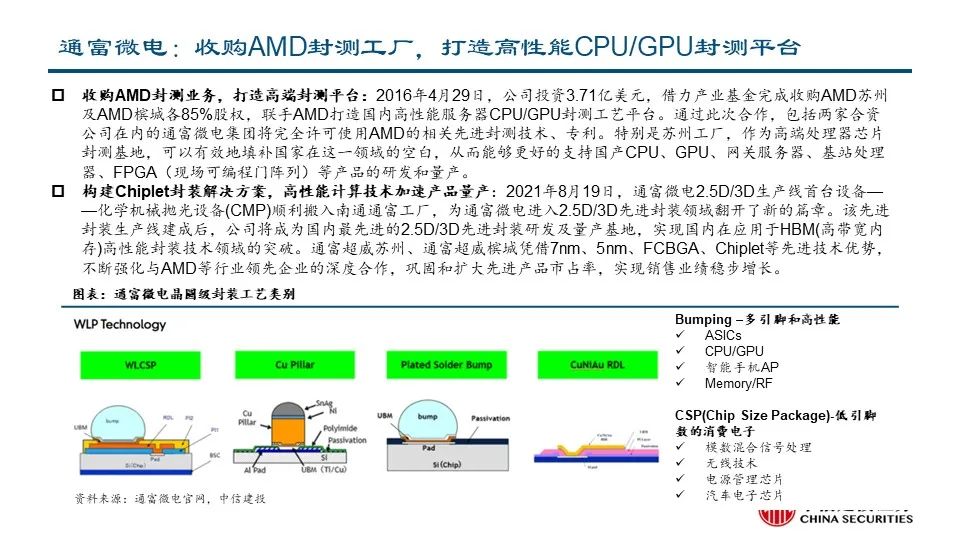
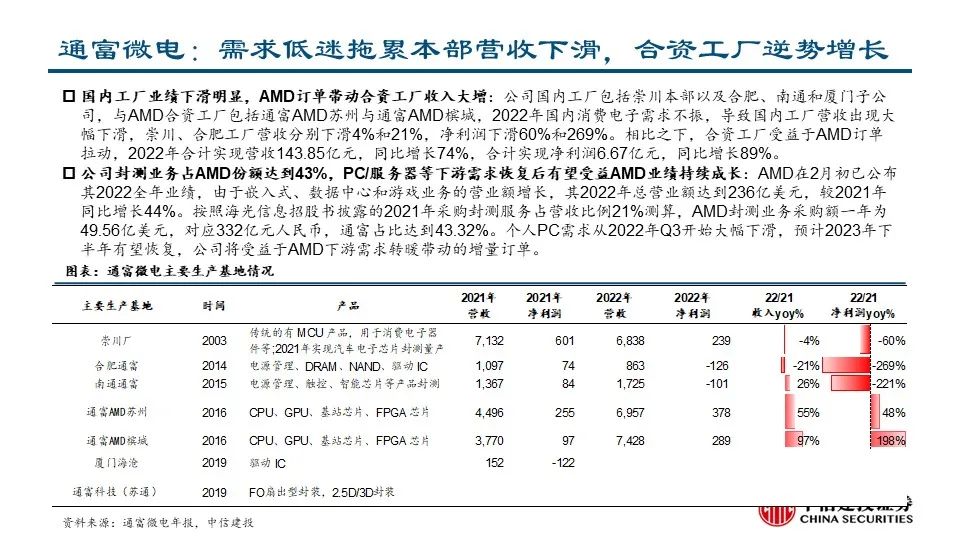


水晶球APP
高手云集的股票社区
X





 公安备案号 51010802001128号
公安备案号 51010802001128号