-
先进封装将一改封测“低门槛、低单价”面貌,后道设备国产化率提升空间大!
研报院 / 2021-10-12 22:56 发布
先进封装将一改封测“低门槛、低单价”面貌,后道设备国产化率提升空间大!
中金公司指出,后摩尔时代,芯片制造面临物理极限与经济效益边际提升双重挑战,先进封装将一改原先“低门槛、低单价”面貌,技术壁垒将不断提升。
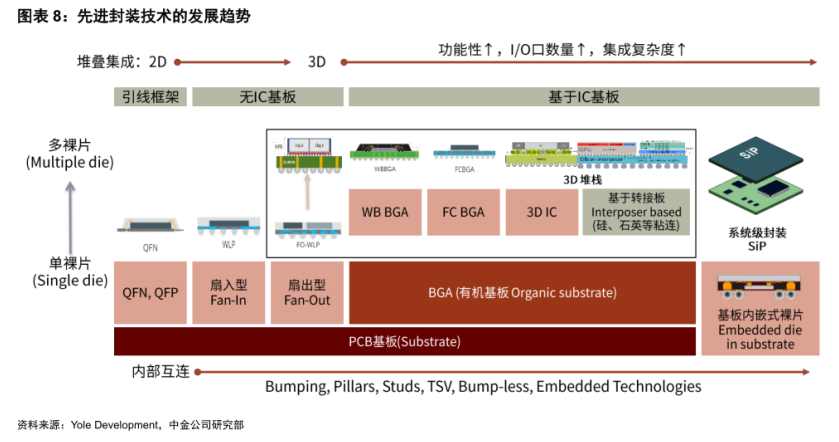
1)先进封装延伸行业定义,龙头封测厂商率先布局加固壁垒
相比传统封装,新形式正快速改写封测行业以低门槛、低单价竞争为主,同质化程度高的行业特征。随着IDM(垂直整合制造商)和晶圆厂入局,前、中道工艺的渗透不断提升先进封装技术壁垒。
此轮技术革新由头部厂家带动,龙头封测厂凭借资金实力和技术积累率先布局,我们认为其优势有望在产能提升后进一步放大。
根据Yole测算,全球先进封装市场规模预计从2020年的300亿美元增至2026年的475亿美元,CAGR为8%。其中,3D 堆叠、扇出型市场规模增速最高,2020-2026年 CAGR 分别达22%/16%。

2)芯片封装设计重要性提升
先进封装突出了芯片器件之间的集成与互联,设计厂商在芯片开发初始阶段就需要考虑到含封装在内、整个系统层级设计和优化。
考虑到先进封装带来更多的诸如散热、机械机构等设计要点,EDA工具服务范围得到拓展。
Chiplet(芯粒)带来硅片级别IP复用的新商机,IP厂商将充分受益。先进封装将一改封测“低门槛、低单价”面貌,后道设备国产化率提升空间大

3)国内中道设备材料已具备竞争实力,后道仍有较大国产替代空间
在设备端,封测产业虽然是我国半导体产业链中最成熟的环节,但后道封装和测试设备、封装材料的国产化率仍然较低,仍有较大替代空间。
而随着中道制造的快速发展,国内前道设备制造商已顺利进入头部客户的产线并已形成较强竞争力。

资料来源:券商研报
风险提示:股市有风险,入市需谨慎
免责声明:文章内容仅供参考,不构成投资建议,据此操作,风险自担!

水晶球APP
高手云集的股票社区
X





 公安备案号 51010802001128号
公安备案号 51010802001128号