-
3C与算力东风起,先进封装加速
吉祥三哥炒家
 / 2023-11-14 18:42 发布
/ 2023-11-14 18:42 发布一、 事件
3C与算力为推动先进封装的重要动力。近期华为、小米、Vivo等手机厂商相继推出新款机型,推动3C行业回暖,从长电科技、华天科技、通富微电等厂商的收入情况来看,也显示3C行业正在回暖;人工智能(AI)引发的算力需求,也在很大程度上推动了先进封装的发展,例如英伟达的算力芯片供货就受到了供应商的先进封装产能不足的制约;而各大厂商都积极推出自身的先进封装工艺,比如台积电就推出了CoWoS、InFO、SoiC-CoW/WoW等工艺并持续不断地迭代。
台积电CoWoS先进封装需求进一步爆发。据媒体报道,继英伟达10月确定扩大下单后,苹果、AMD、博通、迈威尔等重量级客户近期也对台积电追加CoWoS订单。台积电为应对上述五大客户需求,加快CoWoS先进封装产能扩充脚步,明年月产能将比原订倍增目标再增加约20%,达3.5万片——换言之,台积电明年CoWoS月产能将同比增长120%。
CoWoS是台积电的一种2.5D先进封装技术,能够提高系统性能、降低功耗、缩小封装尺寸,也为台积电在后续的封装技术保持领先奠定了基础。据台积电预计,AI加速发展带动先进封装CoWos需求快速增长,目前其CoWos产能供应紧张,2024-2025年将扩产。其中,由于CoWoS设备交期仍长达8个月。根据Yole预测,2014年先进封装占全球封装市场的份额约为39%,2022年占比达到47%,预计2025年占比将接近于50%。在先进封装市场中,2.5D/3D封装增速最快,2021-2027年CAGR达14.34%,增量主要由AI、HPC、HBM等应用驱动。
二、简介
Chiplet在后摩尔时代给中国集成电路产业带来了巨大发展机遇,首先,芯片设计环节能够降低大规模芯片设计的门槛;其次半导体IP企业可以更大地发挥自身的价值,从半导体IP授权商升级为Chiplet供应商,在将IP价值扩大的同时,还有效降低了芯片客户的设计成本,尤其可以帮助系统厂商、互联网厂商这类缺乏芯片设计经验和资源的企业,发展自己的芯片产品;最后,国内的芯片制造与封装厂可以扩大自己的业务范围,提升产线的利用率,尤其是在高端先进工艺技术发展受阻的时候,还可以通过为高端芯片提供基于其他工艺节点的Chiplet来参与前沿技术的发展。
Chiple(芯粒)模式是在摩尔定律趋缓下的半导体工艺发展方向之一。近几十年来,芯片制造工艺基本按摩尔定律发展,单位面积芯片可容纳晶体管数目大约每18个月增加一倍,芯片性能与成本均得到改善。但随着工艺迭代至7nm、5nm、3nm及以下,先进制程的研发成本及难度提升,开发先进制程的经济效益逐渐受到质疑。
Chiplet模式或存在弯道超车机会,该模式将芯片的不同功能分区制作成裸芯片,再通过先进封装的形式以类似搭积木的方式实现组合,通过使用基于异构集成的高级封装技术,使得芯片可以绕过先进制程工艺,通过算力拓展来提高性能同时减少成本、缩短生产周期。总的来说,Chiplet是一种将多种芯片(如I/O、存储器和IP核)在一个封装内组装起来的高性能、成本低、产品上市快的解决方案。
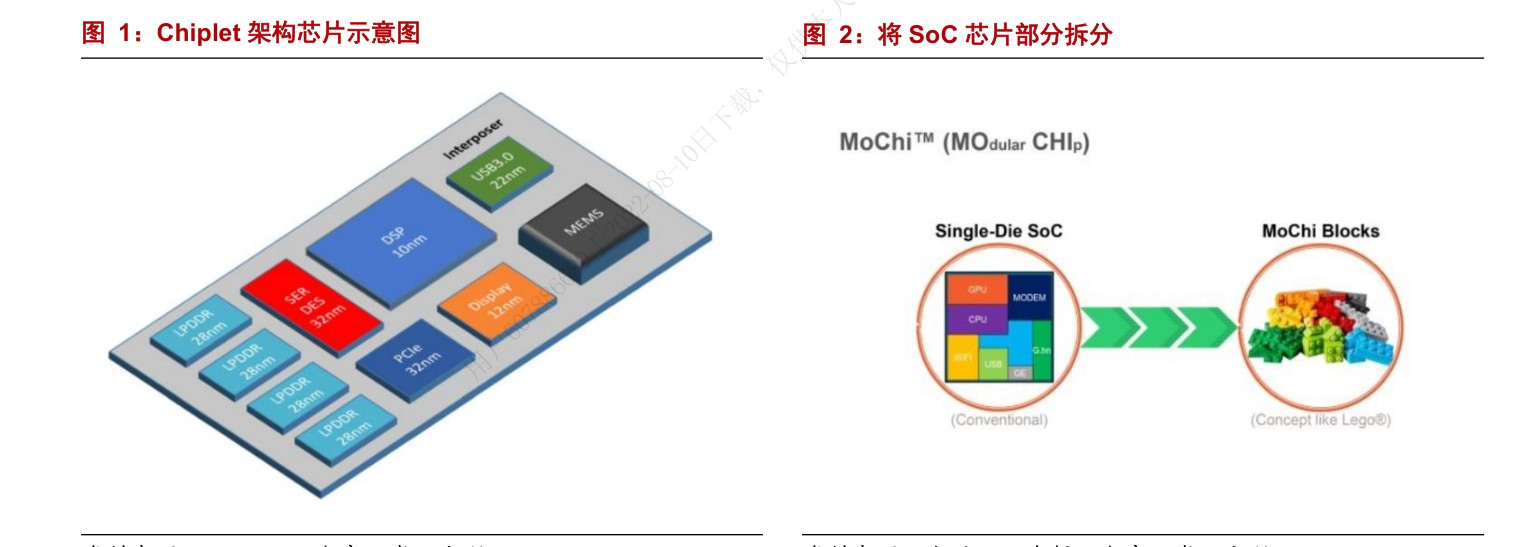 三、行业现状
三、行业现状目前封装方案主要包括5D封装、3D封装、MCM封装等类型
2.5D封装将多个芯片并列排在中介层(Interposer)上,经由微凸块(MicroBump)连结,让内部金属线连接芯片间的电子讯号,再通过矽穿孔(TSV)来连结下方的金属凸块(SolderBump),再通过导线载板连结外部金属球,实现各部件之间紧密的连接。
3D封装则直接将各芯片进行堆叠,在芯片制作电晶体(CMOS)结构,并直接使用矽穿孔来连结芯片间的电子讯号。MCM技术是将多个LSI/VLSI/ASIC裸芯片和其它元器件组装在同一块多层互连基板上,然后进行封装。
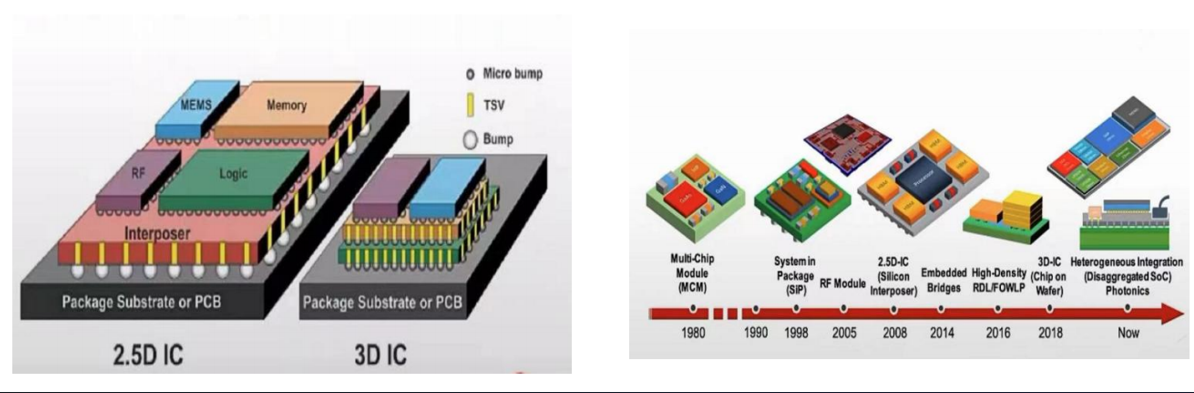
2.Chiplet的发展有利于实现“IP芯片化”
Chiplet由不同功能的裸芯片所构成,与此同时Chiplet的裸芯片实际上是半导体IP经过设计和制程优化后生产出的硬件化产品,一定意义上Chiplet芯片也可以看作是由不同的IP所构成。IP厂商有可能实现从IP供应商到Chiplet产品供应商的转变,从而提升公司在产业链中的附加价值。在Chiplet模式下,设计公司可以买不同公司的硬件然后通过先进封装进行组合,在此模式下IP公司有望实现向硬件提供商的转变。
四、行业前景
与传统的SoC方案相比,Chiplet模式具有设计灵活性、成本低、上市周期短三方面优势,使得该方案成为半导体工艺重要发展方向。
广发证券表示,国产替代已成趋势。由于我国在先进逻辑、存储等方面受到了美国方面的制裁,因此国产化替代成为必选项,客观上也推动了国内半导体行业的技术进步,包括芯片的工艺以及相关的材料、装备等等;以华为为例,除去用于高端手机的麒麟芯片以外,还推出了用于人工智能的昇腾系列芯片以及用于数据中心和云计算领域的鲲鹏系列芯片,积极带动了国内相关产业的发展。
先进封装相关装备为先进封装的进步积极助力。根据SEMI,半导体封装约占整个半导体设备的6%左右,2021年约为72亿美元;对于先进封装,光刻、电镀、蚀刻、研磨切割、注塑、固晶、沉积、CMP、AOI等均为关键装备,国产化率相对不高。
投资建议:(1)推荐芯碁微装,国内微纳直写光刻设备的龙头公司,从PCB向IC载板、平板显示、先进封装等领域拓展;(2)推荐奥特维,公司作为光伏串焊机龙头,持续拓展能力圈,积极研发金铜线键合机、倒装芯片键合机、装片机等半导体设备;(3)推荐迈为股份,公司在先进封装领域积极开拓,与长电科技、三安光电先后签订了半导体晶圆激光开槽设备的供货协议,并在珠海投资半导体装备项目;(4)关注新益昌,公司为国内LED固晶机领先企业,积极向先进封装等半导体领域拓展;(5)关注国内刻蚀设备领先的中微公司,刻蚀为先进封装(TSV等工艺)中非常重要的设备;此外,可关注北方华创、拓荆科技、华海清科、盛美上海、精测电子、光力科技、帝尔激光、德龙激光、华峰测控、长川科技、凯格精机等标的。
水晶球APP
高手云集的股票社区
X





 公安备案号 51010802001128号
公安备案号 51010802001128号